フォトレジスト:ポジ型 or ネガ型?
フォトレジストは、フォトマスク(レチクル)と同一形状のパターンをシリコンウェハ上にコピー(転写)するための材料です。可視光線、X線、電子線などのエネルギーを受けて、化学反応が起こり、露光部の溶解性が変化することを利用して、フォトマスクのパターンを転写します。日本の化学メーカーが大きなマーケットシェアを持つ材料の一つで、信越化学工業、東京応化工業、JSR、富士フイルム、住友化学、Merck、Dowが主要なプレーヤーとなります。
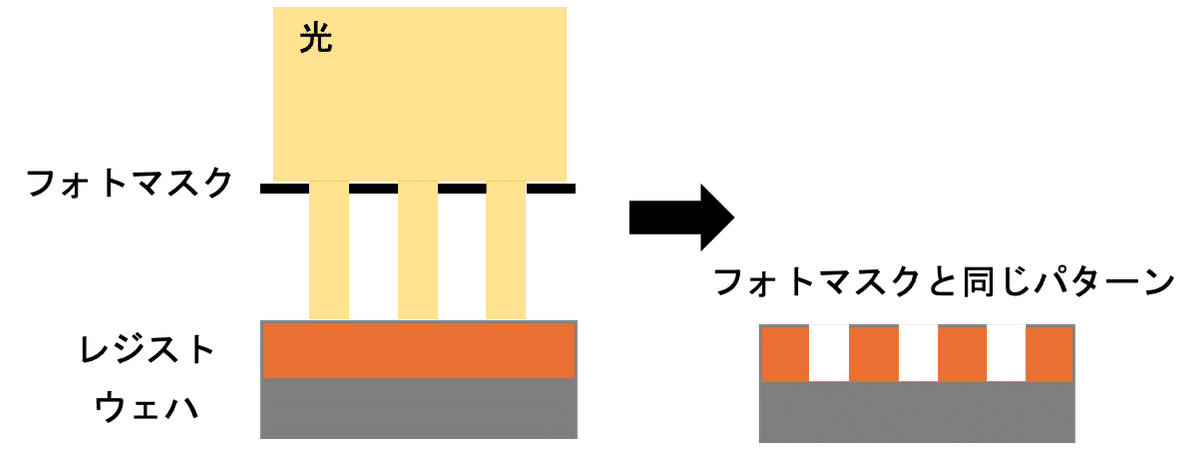
フォトレジストは次のプロセスを経て、ウェハ上にマスクパターン形成を行います。
1. コータ/デベロッパにてスピンコート法によりフォトレジストを塗布・加熱。
2. 露光装置に移送し露光。
3. コータ/デベロッパにて加熱・現像
続く工程(エッチング、インプラ等)後にレジストマスクはすべて除去される為、最終製品には一切残らないことが特徴です。またスピンコートによる塗布時に99%は捨てられてしまいます。スループット、面内均一性確保の為仕方ないとはいえ、エコとは言えない側面があります。
フォトレジストは、露光に伴う溶解挙動の変化で2種類にタイプ分けされます。露光部の溶解性が向上するものがポジ型、逆に低下するものがネガ型です。ポジ型・ネガ型は、転写するパターンに応じて使い分けされています。例えば下図左のような疎なパターンはポジ型が有利となります。なぜならば、露光部が不溶化するネガ型のレジストの場合、ほぼ全面に露光しなければなりません。照射範囲全面への露光は、露光機のレンズ温度上昇を招き、レンズが歪む原因となります。結果、露光の精度が低下するおそれがあります。また、フォトレジストに由来するゴミの影響を受けて、露光機のレンズのクリーニングの頻度が短くなります。その間露光機は使えませんので、処理速度は落ちてしまいます。

続いてはネガ型の使用例です。ピッチ100nmを切るような微細なコンタクトホールのパターン(上図右)においては、ネガ型が有利となります。このレベルの微細加工は液浸型のArF光源を使ったリソグラフィが得意とするところです。MUVやKrF世代では架橋剤を入れることでネガ型のレジストを調合していましたが、大変興味深いことに、通常の現像液2.38wt%TMAHに対して、ArFレジストはポジ型の挙動を示しますが、酢酸ブチルのような有機溶剤を使った現像ではネガ型の挙動を示します。また下図のような段差基板において、スリット部のみを開口したい場合は、ネガ型が有利となります。なぜならば露光に溶解するポジ型は開口したい部分に光を当てて可溶化させなければなりません。しかしながら、深いスリットでは奥まで光が届かず、フォトレジストが残渣として残ってしまうからです。

今回はフォトレジストのポジ型、ネガ型について解説しました。次はMUVレジストの中身について迫りたいと思います。
